【技术文章】通过设计背沟道界面提高垂直薄膜晶体管的电学性能
2023-04-06 16:36:10, Park原子力显微镜 Park帕克原子力显微镜
通过设计背沟道界面提高
垂直薄膜晶体管的电学性能
Kwang-Heum Lee a, Seung Hee Lee a, Sang-Joon Cho b, Chi-Sun Hwang c,
Sang-Hee Ko Park a
a Department of Materials Science and Engineering, Korea Advanced Institute of Science and Technology, Daejeon 34141, Republic of Korea.
b Park Systems, Corp., KANC 15F, Gwanggyo-ro 109, Suwon 16229, Republic of Korea.
c Electronics and Telecommunications Research Institute, Daejeon 34129, Republic of Korea.
虚拟现实、增强现实和全息显示等现代技术在显示设备的探索和各种相关工业应用中受到了相当大的关注。基于这些技术的系统中如果想要提供高质量的图像,必须达到较高的分辨率。由于这些应用通常在移动显示器上实现,因此非常需要将薄膜晶体管 (TFT) 的空间面积降低。使用垂直沟道结构来缩小尺寸的垂直 TFT (VTFT) 是其中一种很有效的方法。但随着显示技术的发展,对分辨率的要求越来越高,VTFT 的尺寸效率也受到了研究人员的较大重视。在制作 VTFT 时,会对侧壁的背沟道区域进行干法刻蚀,这会导致缺陷。因此,必须考虑反向沟道缺陷对 VTFT 性能下降的影响。所以,Kwang-Heum Lee a, Seung Hee Lee a, Sang-Joon Cho b, Chi-Sun Hwang c, Sang-Hee Ko Park a 的研发团队在这方面做出了进一步的研究,对于提高 VTFT 的电性能起到了至关重要(原文链接-https://doi.org/10.1016/j.mee.2021.111676)。在这项研究中,修改了反向沟道接口,以表明其属性会影响 VTFT 的电学特性。通过结构和电学分析,验证了涉及钝化损坏表面或制造更光滑界面的反向沟道界面过程相当大地提高了 VTFT 的电学性能。以下就是具体的实验内容:

图1.(a) VTFT示意图;(b)设备沿 A–A’方向的横截面;(c)VTFT 的光学显微图像,红色条表示沟道区域。
为了研究反向沟道特性对 VTFT 电学特性的影响,研究使用了两种不同的方法。第一个涉及钝化间隔物侧壁的表面(图2(a))在垂直结构的开发过程中,该表面被干法蚀刻较大地损坏。在不存在光致抗蚀剂的情况下进行干法蚀刻以从电极的表面接触区域去除 SiO2 膜。(图2(b))过程称为反向沟道钝化(BCP)。图2(c)–(e) 显示了对测试样品进行的 BCP 过程的 TEM 分析结果。这使我们能够观察到垂直区域新沉积的 SiO2 膜几乎保持原有厚度;这会导致背沟道区域的薄膜表面被新沉积的 SiO2 覆盖,并且与初始间隔物侧壁相比,干法蚀刻对薄膜表面的破坏更小。
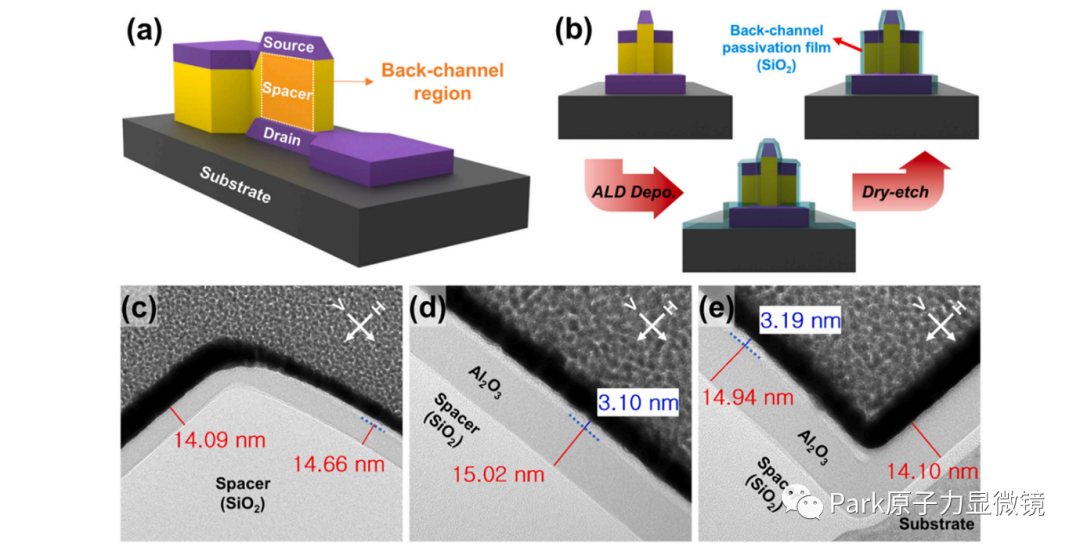
图2.(a)间隔物上的背沟道区域示意图;(b)背沟道钝化所涉及的顺序; (c-d)是测试图案的 TEM 图像表示间隔物的(c)顶部、(d)中部和(e)底部位置。右上角的箭头对应于相对于基底的垂直(V)和水平(H)方向。
将该工艺应用于 VTFT 的制作,结果获得了如图3(a) 所示的背沟道钝化 VTFT(BCP-VTFT)。将 BCP-VTFT 的电学特性与未钝化的参考 VTFT 的电学特性进行了比较如图3 所示。与其他区域相比,发现反向沟道界面不均匀(意味着更高的粗糙度)。众所周知,由于载流子散射,反向沟道界面的粗糙度与 TFT 的电学性能密切相关。因此,为了提高 VTFT 的性能,需要有一个界面更光滑的反向沟道区域。
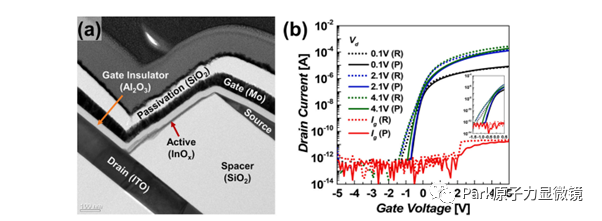
图3.(a)BCP-VTFT 的TEM图像;(b)参考(R)和BCP(P)VTFT的传递曲线。插图显示了在亚阈值区域放大的传输曲线。
考虑到这一点,第二种方法是通过先进的光刻工艺来改善间隔物侧壁的表面形态。图4 显示了从高分辨率和低分辨率光刻(HR、LR)系统获得的间隔侧壁的 SEM 图像。与使用标准投影对准器的 LR 工艺相比,使用步进光刻工具的 HR 工艺在光刻胶掩膜的边缘产生了更陡的锥角。因此,我们可以减少由于垂直高能离子的轰击而在干法蚀刻过程中发生的光刻胶边缘退化,从而减少线边缘粗糙度 (LER) 和光刻胶图案的变形。由于干蚀刻方法的特性,这被转移到下面的间隔物侧壁。因此,HR 方法的样品显示出光滑的表面,而 LR 方法的样品显示出更粗糙的表面,具有更多的缺陷和/或散射点。
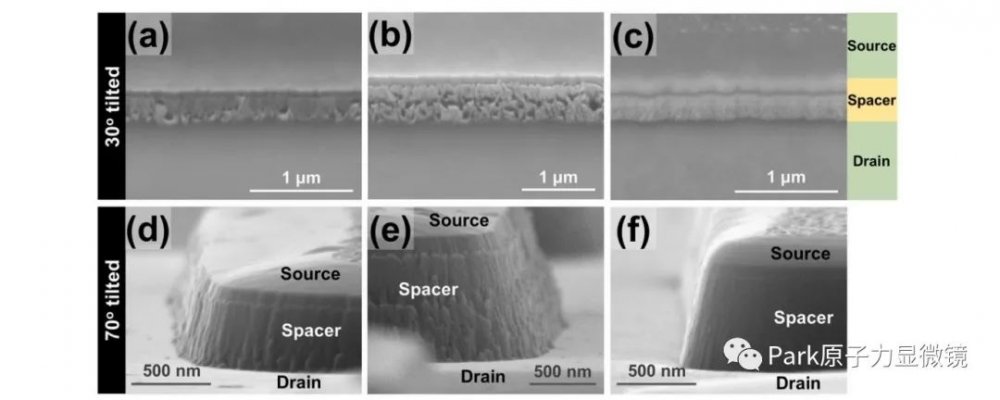
图4.间隔物侧壁的SEM结果以及(a)(d)LR处理;(b)(e)具有1μm厚间隔物的LR处理;(c)(f)HR处理的图像。
利用这些方法制作了三种类型的 VTFT,并分析了它们的传输特性, 这三类间主要且唯一的区别是间隔物侧壁的表面形态。我们可以得出结论如图5 ,间隔侧壁的粗糙度越光滑,VTFT 器件的电学性能越好。

图5.对于0.1、2.1和4.1V的漏极电压(Vds),(a)LR-VTFT、(b)LR-VTFT(带1μm间隔物)和(c)HR-VTFT的传输曲线。红线表示栅极漏电流。

图6.(a)LR和HR工艺的干蚀刻机制示意图,(b)用于侧壁轮廓测量的3D-AFM,(c)RMS SWR、顶部和底部SWA的分析位置,(d)HR-VTFT、LR-VTFT和LR-VTFT(1μm间隔物)样品的3D渲染,以及(e)SWR、底部和顶部SWA的比较。
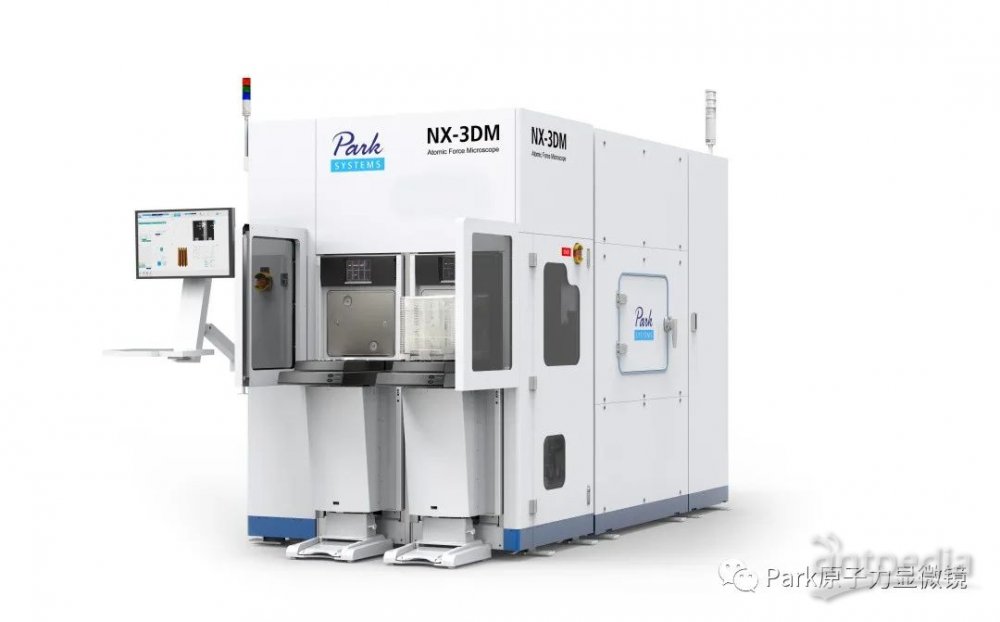
ParkNX-3DM -用于高分辨率 3D 计量的
自动化工业原子力显微镜
最后,本研究还有一个重要的验证过程,即通过在与制作三个 VTFT 相同的条件下制作的源极-间隔物-漏堆叠样品上进行的 3D-AFM,验证了背沟道区域的表面轮廓。3D-AFM 技术是新型先进的原子力显微镜扫描技术,这种新型 AFM 技术与倾斜的 AFM 扫描器(图6(b))和软件校正一起使用,能够获取精准的垂直表面形态和 3D 渲染图像。图6(c)和图6(d) 显示了从 AFM 结果重建的分析位置和 3D 渲染图,而从 AFM 提取的参数总结在图 6(e)中。与 SEM 图像(图4)的结果类似,HR VTFT 样品的侧壁粗糙度(SWR)的均方根(RMS)值最小,而顶部和底部侧壁角度(SWA)最大。该结果也支持之前对光刻工艺与干法蚀刻条件之间关系的解释,如图6 所示。因此,可以得出结论,由高分辨率、基于步进器的光刻胶形成的更陡锥角的光刻胶光刻工艺有助于减少干法蚀刻工艺造成的损坏,并提供更平滑的背面沟道形态,从而改善 VTFT 的电学特性。HR-VTFT 表现出出众的电学性能。此外,这些电学参数甚至可与传统平面 TFT 的电学参数相媲美,这意味着 VTFT 结构可以额外实现具有纳米级沟道长度和更小占位面积的更高电流驱动能力。从这个结果来看,我们相信将高性能 VTFT 集成到下一代显示器中将更接近现实。
电话:400 878 6829
Park北京分公司
北京市海淀区彩和坊路8号天创科技大厦518室
Park上海实验室
上海市闵行区丰虹路199号星月虹桥中心5号楼118
Park广州实验室
广州市天河区五山路200号天河北文创苑B座211
Park台湾分公司
新竹縣竹北市台元一街8號4樓
04-07 为您服务的
Danaher Beacon | 思拓凡与圣拉斐尔特里松基因疗法研究院达成合作,共同推进新一代基因组医学平台建设04-07 丹纳赫
全自动DNA切胶仪精准筛选GUIDE-seq2测序文库,验证CRISPR-Cas9酶变体PAM序列特异性04-07 环亚生物
全自动DNA脉冲场电泳回收仪用于5' 转录组测序及CUT&RUN《Nature》-蚂蚁嗅觉基因选择性表达机制新发现04-07 环亚生物
文献速递|Blue Pippin全自动DNA脉冲场电泳回收仪用于单分子蛋白组学识别技术开发04-07 APGBio
超长测序文库新思路:Blue Pippin全自动大片段DNA脉冲场电泳回收仪用于Ultra Long 文库构建04-07
【育种创新加速器】安捷伦细胞分析方案赋能种质精准筛选04-07 安捷伦科技
吐温降解分析难?安捷伦专用柱方案高效破局!04-07 安捷伦科技
药物分析排忧解难系列 | 如何判定方法参数调整符合药典限值要求04-07 安捷伦科技
会议通知 | 第一届创新药物研发与质量评价技术交流会——小核酸与多肽专题04-07 安捷伦科技
护航锂电分析 | ICP‑OES 炬管陶瓷外管解决方案先行04-07 安捷伦科技
从核心突破到平台赋能:安捷伦携临床光谱流式与“一站式”解决方案亮相 CACLP04-07 安捷伦科技
成都科林分析邀您共赴第二十九届青岛市分析测试学会年会系列学术报告会暨国际科学仪器及实验室装备展览会,期待与您相遇!04-07
10_基于化学电离(Quick-CI)与 MassWorks软件技术对聚合物中添加剂的元素组成进行测定04-07 绿绵科技
上浆剂对纤维表面特性的作用机制04-07 Eric Brendle
科研必看|蛋白组覆盖不足?【阿拉丁】多酶消化策略破局指南04-03 Aladdin
会议预告|【阿拉丁】邀您共聚2026中国(南京)国际科教技术及装备博览会04-03 Aladdin
会议预告|【阿拉丁】与您相约中国细胞生物学学会2026年全国学术大会04-03 Aladdin
会议预告|【阿拉丁】邀您共赴中国化学会第35届学术年会04-03 Aladdin
Eltra 埃尔特 | 航空部件原材料中的氧/氮/氢分析——ELEMENTRAC ONH-Ps04-03 弗尔德仪器