技术分享丨带你深入解析光刻胶产品体系及其应用
2023-12-11 15:04:03 上海微谱检测科技集团股份有限公司

近半个世纪以来,微电子技术凭借极快的发展速度和强大的生命力成为本世纪最具有发展潜力的技术之一。
它深入到人类社会的各个领域,并成为世界各国竞相发展的产业。
微电子产业的更新换代离不开光刻技术和光刻胶的支撑,其中光刻胶是影响集成电路规模、良率及性能的关键因素。
其光刻工艺的成本约为整个芯片制造工艺的35%,耗费时间可占到60%的比重,因此,光刻胶是集成电路制造的核心材料,并伴随着微电子技术的向前发展而不断更新换代[1]。

光刻技术
光刻技术是利用光化学反应原理和化学、物理刻蚀方法将掩膜版上的图案传递到晶圆的工艺技术。
光刻的原理起源于印刷技术中的照相制版,与印刷术不同,光刻工艺并非使用油墨为介质,而是借助光敏物质在受到光照(曝光)后发生的化学变化,完成信息的转移。
光刻技术按照曝光光源可分为光学光刻和粒子束光刻,目前最主要的光刻技术是光学光刻。
在摩尔定律的引领下,光学光刻技术经历了接触/接近、等倍投影、缩小步进投影、步进扫描投影等曝光方式的变革。
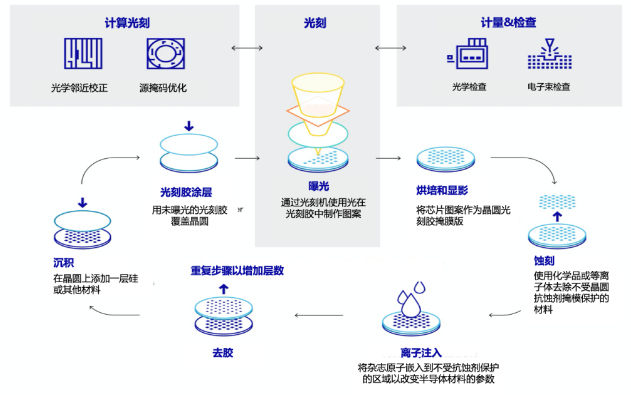
图源:ASML公告、方正证券研究所
光刻胶
光刻胶是指经过不同波长波源曝光后,在曝光区域能够发生交联或者光解,使其在显影液中的物理性能,特别是溶解性或亲疏水性发生变化的混合液体,其光刻原理如图所示:
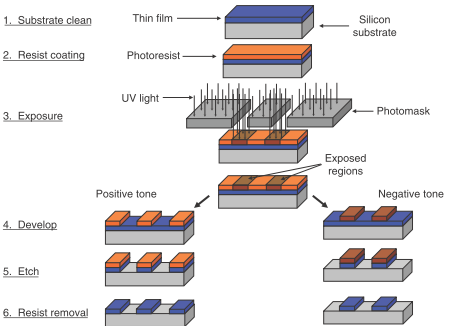
光刻胶光刻原理示意图
光刻胶根据分辨率级别从低到高可以分为G线、I线、KrF、ArF、及EUV。
其中,ArF光刻胶为目前大规模应用中分辨率最高的,而EUV光刻胶则是光刻胶未来芯片的主流材料,光刻胶产品体系与集成电路尺寸可参见下方表格。
光刻胶产品体系与集成电路尺寸
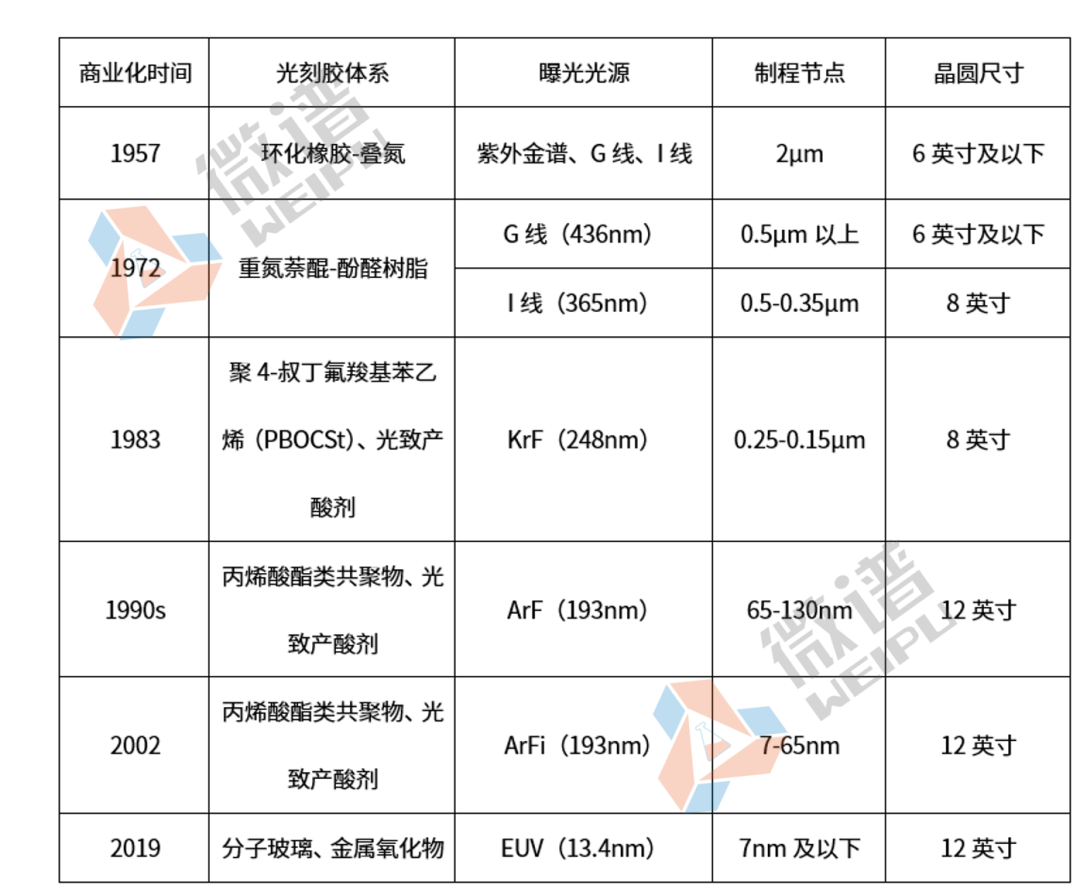
以下对光刻胶产品体系展开详细的介绍:
1
环化橡胶-叠氮
环化橡胶-双叠氮型负型光刻胶是由美国Kodak公司于1958年发明,此类光刻胶在催化剂的作用下,主链部分发生环化反应,形成具有环状结构的低分子量部分,再加入双叠氮感光剂配制成环化橡胶-双叠氮型负型光刻胶[2]。其固化机理如下:

环化橡胶-双叠氮型光刻胶的光化学反应示意图
2
G显/I线光刻胶
目前,商品化的G线/I线光刻胶主要为酚醛树脂-重氮萘醌体系:以酚醛树脂为主体树脂,为光刻胶提供成模性、耐热性以及抗刻蚀性能;重氮萘醌为感光材料,为光刻胶提供感光性能[3,4]。
其感光机理为:在曝光区域,重氮萘醌感光基团发生分解反应,生成氮气,同时分子重排,曝光区域在显影时生成茚羧酸,能够快速溶于显影液;在未曝光区域,由于氢键的作用发生交联不溶于显影液,依靠在显影液中溶解度的差异形成正型光刻胶图形。如图所示:

酚醛树脂-重氮萘醌光刻胶结构及光化学反应示意图[5]
3
KrF光刻胶
由于酚醛树脂在248nm的曝光光源处不透明,与产酸剂存在竞争吸收关系,光敏性较差,因此无法应用于248nm光刻工艺中。
而聚对羟基苯乙烯及其衍生物在248nm处有很好的透过性,通常被用作光刻胶成膜树脂[6]。其常用部分结构如下所示:

聚对羟基苯乙烯及其衍生物结构
此类光刻胶的光化学反应示意图如下所示:

4
ArF系光刻胶
目前已经开发的193nm光刻胶成膜树脂主要有:聚(甲基)丙烯酸酯共聚物、降冰片烯-马来酸酐及其衍生物、有机-无机杂化树脂和光致产酸剂(PAG)接枝聚合物主链型。
首款193nm光刻胶的成膜树脂是由甲基丙烯酸甲酯、甲基丙烯酸和甲基丙烯酸叔丁酯通过自由基共聚而成[7-9]。
研究表明,树脂的含碳量[10]可以提高光刻胶的抗刻蚀性,因此,在成膜树脂中加入脂环族单体可以有效提高含碳量,目前主要开发的有薄荷基[11]、金刚烷基[12-15]、降冰片基[16,17]等。其结构如图所示:

应用于193nm光刻胶成膜树脂典型的(甲基)丙烯酸类树脂结构
另外,光致产酸剂(PAG)是光刻胶的关键组分之一。目前常用的光致产酸剂为硫鎓盐、碘鎓盐以及N-羟基琥珀酰亚胺磺酸酯。

ArF光刻胶主要光致产酸剂
微谱分析技术服务测试案例
微谱作为大型研究型检测机构,致力于通过谱图分析的手段助力国产光刻胶的研发与应用。
因此,对于成膜树脂中所用部分典型的合成单体,我们已做了相关表征与解析,以部分单体的部分测试为例:
1
金刚烷基甲基丙烯酸酯:

样品1-金刚烷基甲基丙烯酸酯的NMR测试结果

样品1-金刚烷基甲基丙烯酸酯的GC-MS测试结果
RT:14.603min

2
羧基-4-降冰片内酯-5-甲基丙烯酸酯:

样品2-羧基-4-降冰片内酯-5-甲基丙烯酸酯的NMR测试结果

样品2-羧基-4-降冰片内酯-5-甲基丙烯酸酯的GC-MS测试结果
RT:16.100min

注:GC-MC谱图所示为错匹配结果,分析过程中主要为相关质子峰解析
微谱拥有专业的技术团队与完善的谱图分析手段,可助力光刻胶生产商进行产品研发与应用。如果您有相关的业务需求,欢迎来电咨询:400-700-8005。
关于我们
微谱,大型研究型检测机构。始于2008年,总部位于上海,在广州、深圳、苏州、南京、杭州、宁波、武汉、长沙、成都、西安、北京、天津、青岛、太原、济南和亳州等地设立有分子公司,拥有超过2000名专业人员,7万平方米以上实验室及办公场地。
基于十多年的专业技术积累和遍布全国的服务网络,微谱每年出具近十万份技术报告,累计服务客户八万多家,其中包括众多世界五百强客户,高端技术水准和高质量技术服务深获客户好评。
微谱始终秉承“服务,不止于检测!”的理念,尽心尽力让科技进步更快,让产品质量更好,让人类生活更安全、更健康、更绿色!



轻松一点,赞和在看都在这儿!

02-19
新年寄语 | 秉承初心 未来可期02-18
开工大吉 | 安东帕正月初九正式开工02-18
行业应用 | Brabender食品和饲料行业02-18
LaVision 推出新一代PIV相机– Imager CX3p 系列!02-18 LaVision
龙年新征程!您的好运开工福利正在派送中02-18
新年快乐,开工大吉02-18
乘龙而上 | 2024先锋科技开工大吉!02-18
谱新生物正月初九开工大吉!02-18
开工大吉|正月初九,鸿运当头02-18 Unimicro
开工大吉 | 粒度仪复工维保工作02-18 Tina
FRITSCH中国区-开工大吉!02-18 FRITSCH
开工大吉,“龙”重登场!02-18 Agilebio
成都科林分析技术有限公司开工啦!02-18
华谱科仪祝您开工大吉!附赠色谱质谱开机技巧!02-18 华谱科仪
【开工大吉】您的实验室实用开工锦囊!02-18
【开机小贴士】月旭助您春节后开机无忧!02-18 仪器事业部
开工大吉,向光的方向出发,迎接新的挑战和机遇!02-18
开工大吉!02-17
高端液相色谱供应商成都珂睿科技有限公司近日完成数千万人民币A2轮融资02-16 珂睿marketing