Advanced Science:高效多尺度的原子力和扫描微透镜显微镜联用技术
2022-08-01 01:21:07 布鲁克电子显微纳米分析仪器部
布鲁克期刊俱乐部 第74期
Bruker Journal Club
布鲁克纳米表面仪器部 李勇君博士
随着微电子学和纳米制造技术的迅速发展,在纳米技术领域,对超高效、高性能微电子器件的需求日益增长,大规模集成电路的特征尺寸不断向纳米尺度发展。半导体制造工艺正在不断优化,以便在一个小的面积内集成越来越多的器件、封装成高度复杂的芯片。在半导体器件制造中,半导体晶圆的错误检测、缺陷定位和分析对质量控制和工艺效率至关重要。因此,器件特征尺寸的减小和集成电路图案复杂度的增加,需要不断提高集成电路成像和检测技术的分辨率和效率。但使用传统显微镜同时提供快速成像和高分辨率成像仍然是一个巨大的挑战。为了提高集成电路特征结构的检测分辨率和效率,需要发展新的大范围、高分辨、快速成像技术。
近日,中国科学院沈阳自动化所的机器人学国家重点实验室微纳米自动化团队提出了一种新的关联成像方法。科研人员将微透镜与原子力显微镜(AFM)探针结合,通过在微透镜表面上沉积AFM探针,将基于微透镜的光学成像和AFM两者的优势结合,实现了三种成像模式:①微透镜快速高通量扫描光学成像、②表面精细结构AFM成像和③微透镜AFM同步成像。
该项研究工作最终以“Correlative AFM and Scanning Microlens Microscopy for Time-Efficient Multiscale Imaging”为题发表在2022年4月的《Advanced Science》杂志上。
文章中,研究者们提出了一种结合AFM和基于微透镜的扫描光学显微镜的无损、高通量、多尺度成像方法。在该方法中,微透镜与AFM悬臂梁的末端耦合,微透镜面对样品面侧包含一个聚焦的离子束沉积尖端作为AFM扫描探针(图1)。微透镜的引入提高了AFM光学系统的成像分辨率。研究者们的实验结果表明,微透镜的引入提高了传统AFM光学系统的成像分辨率,成像放大率提高了3-4倍,有效地缩小了传统光学成像与AFM之间的分辨率差距。与单一AFM成像模式相比,成像速度提高了约8倍。高通量、高分辨率AFM和扫描超透镜关联显微镜为实现微米到纳米级分辨率的跨尺度快速成像提供了新的技术手段。该方法弥合了传统光学成像与AFM之间的分辨率差距,实现了微米到纳米分辨率的跨尺度快速成像,提高了基于AFM的大规模成像检测效率。同时,获得的光学图像与结构信息之间实现了纳米级的关联,为半导体器件的检测提供了有力的工具。
构建基于抗体的病毒-二茂铁复合物
1.AFM和扫描超透镜显微镜联用概述
AFM和扫描超透镜显微镜联用原理示意图(图2)显示微透镜耦合到AFM悬臂端,扫描探针尖端沉积在微透镜面朝样品表面的一面。该微透镜与AFM系统集成,将AFM成像与微球增强光学成像相结合,可同时获取高分辨超透镜光学图像和AFM图像。

2.“微透镜-AFM”探针的AFM成像性能测试
研究者们对“微透镜-AFM探针进行了表征,确定了延长探针尖端寿命和保持微透镜近场成像能力的合适扫描参数。在本研究中,研究者们使用了Bruker公司商用的AFM (Dimension Icon),并将标准的AFM探针替换为定制的微透镜-AFM探针,采用轻敲(Tapping)模式对样品表面进行AFM成像。同时,研究者也采用Bruker商用AFM探针(TESP-V2探针)进行验证。结果表明:微透镜-AFM探针与商用的AFM探针测量结果一致。

3.微透镜-AFM探针的精细结构表征
为了进一步评估微透镜-AFM探针的扫描成像性能,研究者们对包含间距为70 nm的平行线模式(图4k)、具有60 nm特征的复杂模式(图4g)以及间距为50 nm的点和线(图4a)的半导体晶圆进行了AFM轻敲模式成像。结果显示该微透镜- AFM探针精确跟踪了20nm高点和线纹的精细结构,图像畸变很小。对比使用商业探针和微透镜- AFM探针从同一样品区域获得的两幅图像,可以发现,测量到的图案尺寸、形状和高度以及间距几乎相同(图4d)。此外研究者们还使用微透镜- AFM探针扫描了不同间距和不同扫描区域的半导体晶圆图案。结果表明,新型探头可以实现高速下的大面积精确图像和长时间的扫描成像。

4.扫描微透镜的光学成像
研究者们采用了Bruker AFM原有的光学系统用于微透镜的光学成像。在实验中,采用直径为35μm、折射率为1.46的二氧化硅微球作为微透镜,对半导体晶圆表面成像(图5b)。与无微透镜辅助的AFM光学系统的成像结果相比,微透镜成像显著提高了成像分辨率,可以分辨出约300 nm特征的结构,这有助于半导体晶圆的粗检测和定位。
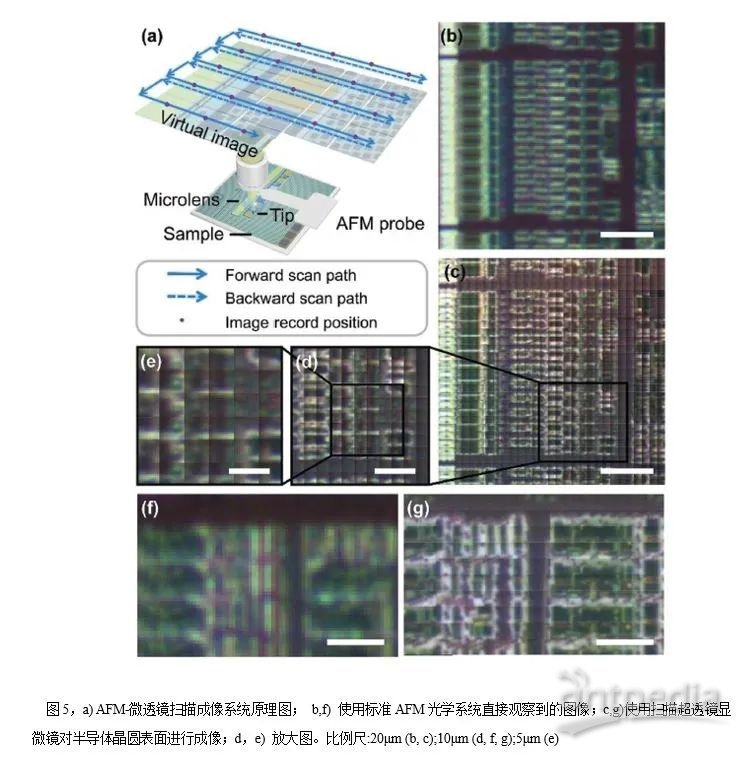
本文相关链接:
原文链接:
Correlative AFM and Scanning Microlens Microscopy for Time-Efficient Multiscale Imaging,Advanced. Science,(2022), 9, 2103902, https://doi.org/10.1002/advs.202103902
Bruker AFM介绍:
https://www.bruker.com/zh/products-and-solutions/microscopes/materials-afm.html
扫码关注
布鲁克纳米表面仪器部
服务热线
400-890-5666
BNS.China@bruker.com
06-05
德国元素耗材之星 | 固体压样器/液体封样器06-05
祝贺嫦娥六号月背采样成功 | 盘点标乐助力月球样品分析06-05
2024年德国元素巡检活动 | 第一站:成都站!免费申请06-04
会议通知|第一届小动物活体成像技术前沿与应用网络研讨会06-04
蛋白质组学从发现组学跃入临床怀抱的跨越之旅06-04
内毒素检测的思考 - 采用药典方法同时减少鲎试剂的使用06-04 Sievers分析仪
检测家十周年特惠 | 赛默飞、岛津、沃特世 系列产品租六送一!06-04
转发:上海交通大学李林森团队&德克萨斯大学奥斯汀分校刘宜晋团队EES发文:多尺度相关成像揭示快速充电电池中的顺序性和不均匀性退化06-04 TESCAN中国
颠覆认知 “质”的飞跃 | 持续引领行业,赛默飞重磅新品发布06-03
携手同行,共创未来|纽迈2024团建活动圆满结束06-03
研发创新:杨培强与纽迈分析的科研旅程06-03
【圆满举办】2024中药材及饮片质量安全检测技术培训交流会(甘肃站)06-03 检测家
一地发布 检验检测「黄金十条」!通过全国重点实验室认定,最高资助1000万!06-03
实验室溶剂混溶表06-02
专家在线开讲 | 北京市食检院 林立主任:GB5009.8-2023标准修订情况介绍06-02
前方高能预警:来自00后的实验室警告06-01
专家在线开讲 | 任一平教授:GB 5009.296-2023 标准解读及应用06-01
每年给小孩做一次超声检查,有必要吗?|写在儿童节06-01
激发创新活力-推进兴粮兴储|开元弘盛参加全国粮食和物资储备科技活动周06-01 开元弘盛