Vocus CI-TOF半导体AMC快速精准检测
2022-05-12 09:10:22, TOFWERK TOFWERK中国-南京拓服工坊
“ 我们将简短回顾AMC类别,AMC对洁净室环境和晶圆可能造成的负面影响,以及Vocus CI-TOF质谱仪在多个半导体应用场景下对多种AMC的监测案例”
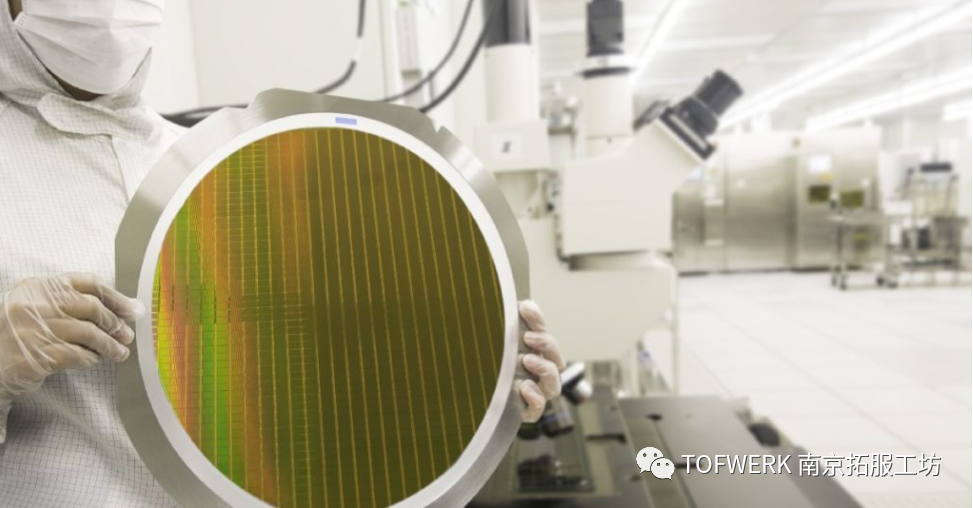
01—
背景介绍
越来越精密的半导体制程工艺和同步的高良率目标,不仅仅对晶圆加工设备和运行参数需要精益求精,对洁净室中可能存在的气态分子污染物(AMC)的监测和管控需求也越来越高。随着半导体制程趋近于摩尔极限:纳米(nm)级别的蚀刻尺寸和更高密度的晶体管密度,洁净室内空气中的各种‘杂’分子如果沉积到晶圆表面,都可能会影响到工艺效果。同时由于现代工艺的复杂性和众多步骤,这些影响都会不断传递并放大,最终体现在晶圆良率上。
换个角度来说,AMC污染物的检测技术手段也需要跟上不断进步、追求极限的半导体制程工艺的步伐。根据文献报道和相关研究,为最大程度减少AMC对工艺良率的影响,洁净室内的重点AMC浓度需要控制在万亿分之一(pptV)的级别。在达到高灵敏度的同时,快速响应也是一个重要指标,从而提高样品测量通量,并在AMC浓度异常时尽早发出警报,从而避免或者减少对工艺和晶圆良率的负面影响。
半导体生产车间内的AMC的来源分为外部和内部源。外部主要来自于供应给洁净室内部的空气净化和过滤系统。内部则可能来自于多个源头,包括工艺残余、FOUP污染、清洁溶剂使用、工作人员相关、洁净室内材料逸出等[1]。晶圆在洁净室内需要经历上百个制程,多个工艺设备以及时长不等的储存,这也意味在某个环节对某批次晶圆的污染也会不可避免的波及到下游工艺相关环节以及后续批次的晶圆。
半导体业界对部分AMC的来源以及它们可能对晶圆产生的影响有大致了解和认知,但对其它AMC的存在和可能影响还是一知半解。现在市面上能够实时检测并出数,并能高灵敏度覆盖大部分目标AMCs的检测手段在半导体产业还没有常规使用或者缺失。Vocus CI-TOF质谱仪,借助于多年在大气监测科研领域的硬件开发和经验积累,在半导体洁净室这一方‘微环境’内的应用能全面胜任。
本文中,我们将简短回顾AMC类别,AMC对洁净室环境和晶圆可能造成的负面影响,以及Vocus CI-TOF质谱仪在多个半导体应用场景下对不同AMC的监测案例。
02—
气态分子污染物(AMC)

图1.基于国际半导体设备和系统线路图,不同制程节点要求下洁净室内AMC上限浓度一览。
气态分子污染物(Airborne molecular contaminant,AMC),是对半导体制程良率可能产生负面影响的气态污染物的统称。2007年发布的ITRS国际半导体技术发展蓝图对AMC的基本种类进行了定义:酸类(MA)、碱类(MB)、可凝结物质(MC)和掺杂物质(MD)。十年后,蓝图的继任IRDS设备和系统线路图中,业界开始认识到需要关注的AMC物种远远不止上述种类。随着制程工艺节点越来越小,工艺复杂度和步骤不断增加的大前提下,洁净室内的AMC数目和类别也会持续增加。
现行的AMC检测方法普遍受到仪器数据输出频率低或者物种覆盖范围较小的限制。例如常见的在线色谱质谱联用通常每30分钟才能出一组数据,而且耗材和维护人力成本较高。另一类常见的在线分析方式是光谱法,比如以光腔衰荡光谱(CRDS)为代表的激光吸收光谱技术。因激光光源限制,一台CRDS设备一般只能检测一种或者几种化合物,同时数据时间分辨率是分钟级别。这也是IRDS路线图中对各种类的AMC都推荐某几种设备组合的主要原因。
Vocus CI-TOF质谱仪是AMC检测技术的强力补充。只需一台仪器,业主就可以覆盖AMC的几大主要种类,同时获得秒级响应和pptV级别的检测限。搭配的高分辨率TOF飞行时间质谱的全谱记录让Vocus CI-TOF具有数据回溯分析的功能,这在半导体需管控AMC种类不断扩充的前提下显得尤其重要。上述这些优点也使得Vocus CI-TOF质谱仪成为要求苛刻的洁净室AMC检测需求的解决方案首选,从而确保车间内空气质量保持稳定和‘低调’,不成为影响晶圆产率的因素之一。

图2.Vocus CI-TOF与其他分析技术的参数对比
酸类物质 (MAs)
酸类物质,尤其是无机酸,对晶圆良率的负面影响是半导体从业者的痛点之一。酸会腐蚀晶圆表面的金属线或表面,形成颗粒物沉积到晶圆表面,损坏光刻掩模,以及弱化HEPA滤膜性能。HEPA滤膜材料劣化会导致过滤系统效率降低,也有一定几率会产生含硼化合物和其他影响到半导体工艺和晶圆良率的污染物。痕量酸类物质与晶圆良率的具体关系其实至今还没有系统性的研究,其原因可能在于快速精确检测pptV浓度有机/无机酸的检测设备在半导体行业还没有得到广泛使用。2017年度IRDS设备和系统线路图中列出的分析技术手段对于酸类物质的检测限是100 pptv或更差,而同一份线路图中也明确列出了在半导体工艺达到5 nm或者以下时,洁净室内的无机酸浓度总量建议控制在5 pptV或更低。无机酸检测需求和现有技术手段的落差可以被Vocus CI-TOF质谱仪填平。在之前的《半导体晶圆运输盒AMC污染快速检测》一文中,较好的展示了Vocus CI-TOF针对各种痕量无机酸的检测能力。
碱类物质(MBs)
氨气、有机胺和酰胺等含氮分子在AMC中是相对特殊的存在。这些碱类分子会在空气通过简单的,也是最常见的酸碱成核机理,产生盐类为主的颗粒物,会有很大可能沉降到晶圆表面或者洁净室内各种外表面。更值得注意的是,氨气对铜等金属表面具有很强的吸附性,对金属参与的制程和仪器内外表面都会产生持续时间较长的污染。氨气一直是在AMC的监管清单之中,近年来,业界也不断发现各种有机胺和酰胺物质的存在在洁净室环境内对光刻和蚀刻等工艺施加的不良影响。为了更有效的减少MBs对制程和良率的负面作用,需要对洁净室空气中存在的多种碱类物质进行精确的长期监控,从而系统化理解它们的气态浓度与工艺效率之间的相互影响。
Vocus CI-TOF前期实验结果清楚的显示了碱类物质在FOUP内表面的停留时间要长于酸类物质。换个角度来说,FOUP或者其他设备表面存在碱类物质污染的话,需要冲洗的时间或者清洁技术都可能需要更多的考量。前段提到的酸碱结合生成颗粒物的这一过程,也强调了需要在洁净室内同步观测酸类物质和碱类物质的重要性。Vocus CI-TOF可以秒级检测pptV痕量酸和碱分子的能力使其成为洁净室空气、FOUP和车间供气内MA和MBs测量的优选之一。
可凝结物质(MCs)和挥发性有机物 (VOCs)
该AMC种类主要有塑化剂、有机磷酸盐、抗氧化剂、硅氧烷和其他VOCs。MC物种的可凝结特性意味着在酸碱成核反应之后,MC会凝结到细小颗粒物外表面,促进其生长,也就相应的增加了沉降几率和对晶圆表面的危害程度。同时MC也会以分子态或者单分子层凝结到晶圆或者设备部件表面。例如,丙二醇单甲醚乙酸酯PGMEA的水合产物之一,乙酸会对晶圆表面和光刻掩膜表面形成雾化污染。又如,含硅有机物沉积在光刻棱镜表面后会对整体光学系统的散射性能产生影响,这在EUV室等要求及其苛刻的环境中尤其值得重点关注[1]。
03—
半导体应用案例
洁净室AMC实时监测
除了生产安全和能耗之外,半导体洁净车间(也称无尘室)设计的另外一个目标是最大化产品产量和良率[4]。之前文献报道了良率和洁净室内空气质量的相关性研究。为了迎合这方面需求,洁净室一般根据每单位体积内的颗粒物数浓度和大小分布进行分级,对应的也会配套相应的空气清洁过滤系统。同样重要的是对洁净室内空气中的颗粒物和颗粒物前驱物进行实时监控,保证洁净室100%满足对应的ISO等级需求。
洁净室内的污染来源一般有人员相关(比如呼出气体)、通风系统效能、车间内材料逸出、清洁溶剂使用、工艺或设备原材料泄漏等等。即便在最高等级的洁净室环境内,Vocus CI-TOF质谱仪也检出很多种物种。图3展示了Vocus CI-TOF在一间ISO6等级的洁净室内的空气检测结果,包含了多个AMC种类:无机酸、VOCs和含氟有机物(PFAS物种)等。
图3.某间ISO 6等级的洁净室内Vocus CI-TOF采集到的谱图,多种类的AMC同时被Vocus CI-TOF检出。
材料逸出
洁净室内对晶圆良率影响最大的材料逸出源头,也是与晶圆相处时间最长的部分,是负责晶圆在不同厂区位置间运输和制程间存储的前开式晶圆传送盒,简称FOUP。现代半导体制程中,晶圆除了在不同原理的设备内部被加工之外,在厂区内的其余时间都在FOUP内度过。文献中已经报道过‘上批晶圆->FOUP->后批晶圆’为顺序的交叉污染[2][3]。同一批晶圆在产线上都有着专属的FOUP,不太可能出现FOUP交叉污染,但也不排除出现‘FOUP->晶圆->设备->下批晶圆->对应FOUP’的可能性。因为材料逸出的‘慢’属性,也意味着晶圆在污染FOUP内部时间越长,受到污染的可能性和程度都会相应提高。
我们之前利用Vocus CI-TOF,对FOUP内的残余的MA和MB物质进行了长时间不间断的跟踪测量。结果表明,在连续冲洗10小时之后,FOUP内仍有痕量pptV浓度的酸类物质检出,这也充分证明了酸类物质的去除难度极大,以及Vocus CI-TOF在此类应用中的不可或缺性。
上述的模拟FOUP逸出实验很好的验证了Vocus CI-TOF技术的快速响应、pptv级别的检测限和高精度、也展示了Vocus CI-TOF在FOUP相关应用上的巨大潜力。一个现成的应用是将Vocus CI-TOF 集成在FOUP清洗站内,实时提供每个FOUP的清洗状态,并相应调整清洗程序参数。另外一个应用是利用Vocus CI-TOF质谱仪不间断的实时检测并反馈各类工艺设备晶圆装载端口内的气体质量,从而将FOUP或者晶圆对制程设备产生交叉污染的可能性降到最低。
TOFWERK推出的Vocus CI-TOF是针对半导体不同环境中,各种类AMCs实时、高灵敏度、高精度监控案例提出的革命性解决方案。该仪器高水平的软硬件集成度、极低的操作运行和维护成本、以及未来大有用处的高移动性都可以解决现有市面上其他仪器的多个痛点,也为业主在提升整体良率、AMC事件预警、实时排查和后续案例分析和总结等需求,提供最佳的投入回报比。
参考文献
1. Den et al. 2020. Doi:10.1149/2162-8777/aba080
2. Nguyenet al. 2013. Doi:10.1016/j.mee.2012.04.008
3. Jeonget al. 2019. Doi:10.1109/ASMC.2019.8791794
4. Den et.al. 2005. Doi:10.1149/1.2147286
06-13 沃特世
时代印记,可靠之选 | Alliance HPLC经典二十八载06-13 沃特世
沃特世发布全新代谢组学和脂质组学软件06-13 沃特世
【快讯】探索无界,加速转化 | 2024“科学空间”系列前沿对话峰会之“探索与转化的加速可及”在沪成功举办06-13
后节手术: 利用术中OCT技术的好处06-13 徕卡显微系统
徕卡精准空间生物学解决方案 第二弹06-13 童昕
快速、可靠的清洁度分析解决方案06-13 徕卡显微系统
以完整的深度揭开生命的奥秘06-13 徕卡显微系统
药包材新公示首个LCMSMS法,揭秘金属涂层中“隐形杀手”双酚A06-13 分析中心
特色应用(二) | SPME-GC-MS/MS研究不同储藏年份玉米风味物质差异06-13 创新中心
岛津连续八年入选“健康经营优良法人 ~White500~”06-13 企划部
共创美好记忆 --记2024年岛津上海分公司家庭日活动06-13 岛津上海工会
岛津招聘 | 风险合规专员06-13 人事部
质谱成像大讲堂丨如何获得一张完美的组织切片?06-13 分析中心
labtech2024 正式启幕丨4大主题洞察实验室用户需求,你的议题你做主!06-13 labtech
仪器行业新机遇:全国推动大规模设备更新!06-13 Sielin
有奖 | 标乐面向全球征集微观结构美图06-13 标乐中国
连续流快速原子荧光技术的开创者06-13
蚊子为什么专咬我!"吗喽" 的命也是命......06-13 小 M
干货分享 | 活性氧 ROS 检测攻略大全!06-13 小 M