
诚信认证:
工商注册信息已核实! 扫一扫即可访问手机版展台
扫一扫即可访问手机版展台
Attolight 定量阴极荧光技术助力氮化镓 HEMT研究
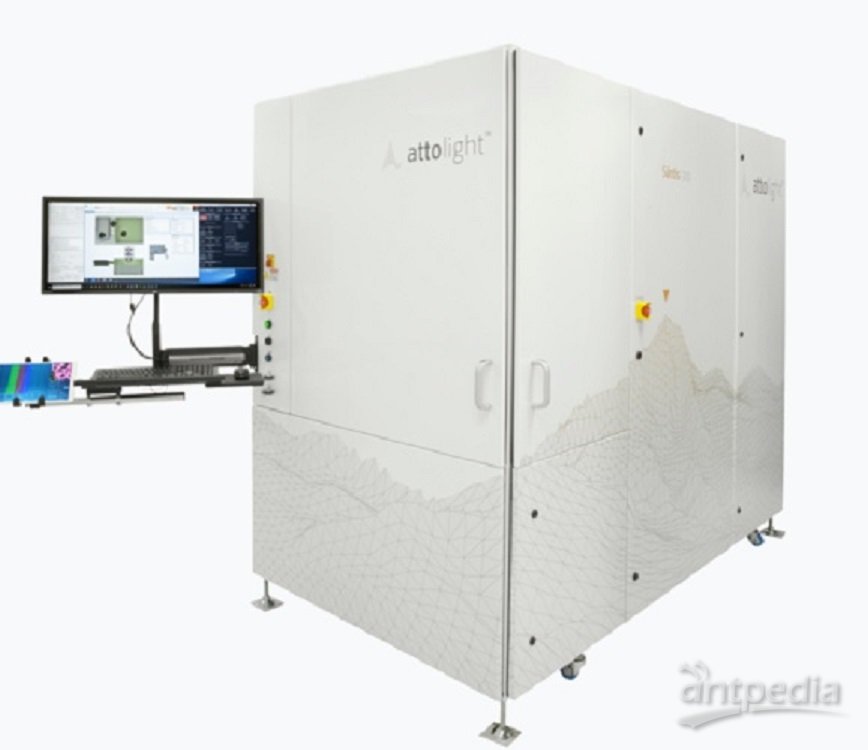
通过定量阴极射线荧光技术进行无损检测,详查氮化镓 HEMT 的穿透位错,组分和掺杂,有助于氮化镓 HEMT 的开发和生产。
MATTHEW DAVIES 和 CHRISTIAN MONACHON ,ATTOLIGHT
化合物半导体具有硅的很多特性,但也有一些显著差异,这导致一些针对硅的表征技术无法为化合物半导体提供准确信息,对于氮化镓来说尤其明显。为了保持有竞争力的价格,氮化镓晶体管和 LED 生长在异质衬底上,因此外延层的缺陷密度非常高,但这从来不会发生在硅基器件上。
一种被称为定量阴极荧光光谱法的无损技术,可以帮助阐明各类化合物半导体器件的特性,其中包括由氮化镓制成的器件。位于瑞士洛桑的Attoligh 团队是这一领域的开拓者,已经推出了支持这种计量方式的工具。
之前,我们的团队发表过有关定量阴极射线荧光技术协助太阳能电池,照明和显示技术领域的制造商的文章(具体可参考《化合物发光技术的阴极射线管发光》,2018 年 7 月版的《化合物半导体》)。本文将探讨,对于硅上氮化镓 HEMT器件,该技术是如何监测其异质结构的质量(如果您不熟悉该器件,请查看“氮化镓 HEMT 的基础知识”部分)。
GaN HEMT 的基础
结型常关 HEMT[1] 的核心是在宽带隙 AlxGa1-xN(x 通常为 10 %至20%)和常规氮化镓之间的界面上形成的二维电子气(2DEG)。为了确保常关操作,p 型掺杂的氮化镓层被插入在铝镓氮层和栅极触点之间。
对于采用这种设计的器件,性能会受到以下因素的极大影响 :
• 位错密度 :位错最终与泄漏电流有关 [2]
• p 型氮化镓中的镁浓度 :这会影响栅极下方氮化镓的费米能级,并最终影响器件的阻断能力
• 铝镓氮中的铝浓度 :这直接影响 2DEG 浓度 [3]
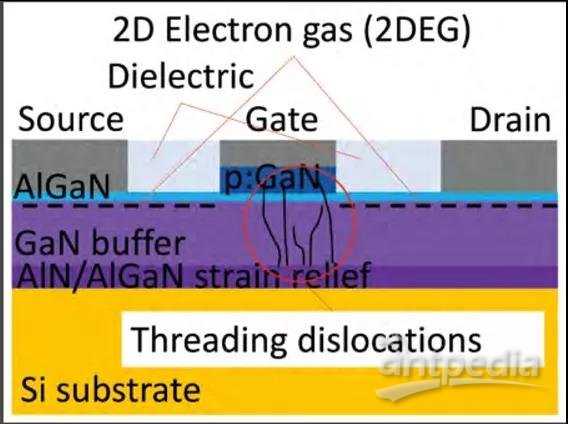
这是结型常关 HEMT 的一般设计,通常用于功率转换应用。整个样品中均存在穿透位错。该草图仅表明了它们的存在和方向,尤其是在结下方,在这里它们可能会产生最大的影响。
对于这类晶体管,定量阴极射线荧光技术帮助工程师通过关注以下三个关键指标来优化生产线的成品率 :穿透位错密度、沟道上方铝镓氮层的铝含量和 p 型氮化镓栅极的镁掺杂量,这是实现常关型 HEMT 的关键。
为了确保最优流程管理,工程师需要在流程中的每个步骤采用来自测量工具的快速无损反馈。对于试生产线,以及专用研发设施和大容量晶圆厂中的生产线来说,都是如此。对于从事研发的生产线来说,更快的反馈速度带来更快的开发速度和开发效率,同时降低成本。在大批量生产的晶圆厂中,更快的无损反馈减少了在制品,在理想情况下有助于快速的工艺控制,对于给定的工艺步骤,有效在制品为零。在工序间隔的停机时间中,在后续过程之间有来自计量工具的反馈,例如在清洁 Epi 反应器时就会发生这种情况。
使用在外延片生长之后的 Säntis 平台,可针对各类指标提供快速,可靠,非破坏性的反馈,在此之前,这些反馈只能通过破坏性而且耗时的方法来获得。有了这种新型高分辨率的外延晶片检测平台,晶圆厂的负责人和工程师可以很好地做出关键性决策,包括对关键性能指标的即时反馈,确定某些晶圆是否应进行前端处理以及是否需要调整生长配方。
在后面的段落,我们将介绍使用 Säntis300 全晶片定量阴极荧光平台对氮化镓 HEMT 进行研究的成果,包括为功率 HEMT 开发的专有测量和分析方法,代表了在氮化镓制造中用于外延工艺控制技术的发展现状。
确定位错
氮化镓 HEMT 性能降低的原因是穿透位错。如果它们与二维费米气体形成的通道相交,或将衬底连接到栅极触点,则可能会导致器件泄漏电流 [2],并可能损害器件的长期耐用性。氮化镓HEMT 的开发人员设计出几种解决方案,以减少通过这些通道的泄漏电流。但是,相关工作人员仍需对此问题进行全面了解,他们并不完全了解位错电流泄漏的原因或有效控制泄漏的方法,而且并不知晓影响位错对器件性能和耐用性的影响。因此,有必要分析外延层中的穿透错位,有助于我们更加了解此问题及控制过程,从而获得更好的器件。
阴极荧光已经存在了几十年,因此人们通常认为使用这种技术计算穿透位错是微不足道的。但事实并非如此 :阴极荧光要比最初看起来要复杂得多,以确保穿透位错密度符合过程控制度量标准。
但是,定量阴极荧光非常有洞察力的,结合了简单的穿透位错计数和许多新指标来确定其密度。包括穿透错位的局部空间分布、伯格斯矢量和大小,以及区分这种缺陷和其他结构缺陷(例如 V 形凹坑)的能力。定量阴极荧光光谱法具有广泛功能,更是用于氮化镓 HEMT 开发和生产的强大工具。
机器视觉是一种可能有助于定量阴极荧光的技术。近年来,该技术得到了改善,因此广泛应用在各行业中。但是,将机器视觉应用于小而密集的特征时会遇到一些麻烦,例如在硅基氮化镓HEMT 外延层中发现的穿透位错簇。在这些异质结构中,平均每平方微米大约有十个穿透位错,传统的特征检测算法可能会降低精度。
我们采用一种创新的图像重建方法解决了这一问题,该方法利用了蒙特卡洛和数值模拟的结果以及特定材料知识和假设。在研究了不同图像上的数百次迭代之后,我们确定了重建的可再现性,以 3σ 的方式评估为 ±1.05%(见图 1)。此外,与基准特征检测解决方案相比,我们的技术可解决多达 40%的缺陷。


图1.(a)带有突出显示的Attolight图像重建解决方案识别出具有穿透位错的阴极发光图像。(b )基于图像重构算法的数百次迭代后的归一化穿透位错密度的直方图。
将通过定量阴极荧光得到的穿透位错成像用于过程控制,其功能不仅限于对单个图像的缺陷进行精确计数。为了使检测精度最大化,工程师应该记录较少的高分辨率图像,每个图像具有较少的特征。但这可能无法同时保证准确性和采样误差的。这对于使定量阴极荧光在过程控制中发挥重要作用至关重要。
如图 2 所示,当使用较小的图像确定穿透位错密度时,更少的特征被展示 - 并且图像更容易受到随机统计波动的影响。尽管单个图像可以对穿透位错提供更精确检测,但在某些情况下,采样误差会覆盖此增益,从而导致结果的准确性较低。


图 2 . ( a ) 当 在 单 个10×10μ m2图像中考虑恒定图像区域(FOV)时,变化的穿透位错密度的不确定性(表示为期望值的百分比)。(b )对于恒定的穿透位错密度为1×109 cm-2的不确定性(表示为期望值的百分比),针对具有变化的FOV的单个图像进行评估。
例如,视野较小的单个图像。由于随机的统计波动,可能导致很大范围的可能值,较低的穿透位错密度会加剧这种影响。在极端情况下,当对缺陷密度为 1×109cm-2 的样品成像时 - 相当于每平方微米平均有 10 个缺陷 - 在单个 2×2μm2 的视野中发现缺陷的可能性很小但不等于零(图 1(b)所示)。
解决方案是将高采样率与优化的视野结合起来。尽管这种方案可以最小化采样误差,但无法以高精度处理无限大视场的图像。为了实现采样率,保证过程控制度量工具有足够的可重复性和可再现性,需要具有出色可靠的自动化功能和可
重复的检测算法。我们将以下功能结合在一起 :Säntis300 平台的自动化,并适当考虑了采样误差和可重复性 ;通过创新的方法,采用专有的图像重建方法来检测特征。
外延层成分
无论是常开还是常关,每个 HEMT 的核心都位于铝镓氮层,该层与二维电子气通道的形成密不可分。通过仔细控制铝镓氮层的生长,工程师可以设置电子气浓度并最终确定关键特性,例如阈值电压和导通状态串联电阻。
氮化镓 HEMT 异质结构的生长从未完美。由于外延反应器的设计,衬底的弯曲以及生长过程的动力学,出现了与外延层的成分和厚度相关的径向晶圆级依赖性(见图 3)。它们在关键层上产生的变化 – 对于 HEMT 来说,关键层是铝镓氮层,在 LED 中是有源区 - 会降低晶圆级的均匀性和器件良率。尽管无法对关键外延层进行计量和监控,但它们在最大程度地提高均匀一致性和生产良率方面起着至关重要的作用。
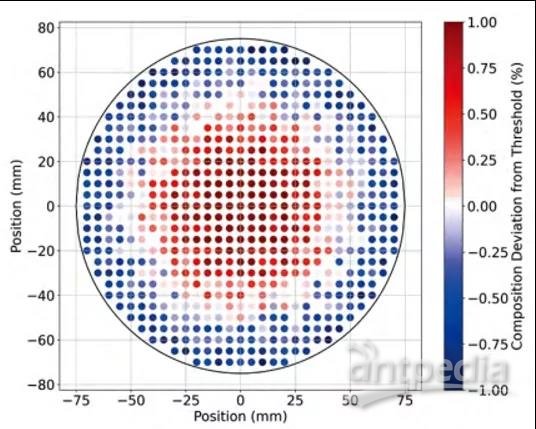
图3.Säntis300平台能够生成氮化镓HEMT结构中埋入式铝镓氮层的铝成分的晶圆图(模拟数据)。
一种被非常广泛采用的可以快速确定外延层组分的方法是测量光致发光的峰值。但是,这并不适用于所有外延结构,包括被氮化镓包层包围的铝镓氮层埋层。当埋入铝镓氮层时,其相对于相邻氮化镓层的能量状态在光激发下会导致极低的发射速率。更为复杂的是,铝镓氮层的激发过程效率低下,尤其是在其上方的层吸收最多(即使不是全部)入射激光的情况下。由于这两个因素,无法测量掩埋的铝镓氮层的光致发光。
想要克服这问题,要么在沉积铝镓氮层之后中断生长,要么通过蚀刻其上方的材料来暴露铝镓氮层。两种选择都是破坏性过程,因此都不是理想方案。无论是蚀刻晶片还是中断生长,用于光致发光测量的材料都不能加工成器件。由于测量是在陪片上执行的,因此这个方法的另一个限制是涉及间接反馈。
我们的方法提供了一种更好的替代方案,即调整电子束的穿透深度,精确有效地激发掩埋的铝镓氮层。通过使用嵌套量具对比研究,具有和不具有顶部 p 型氮化镓层的等效晶片,证明了我们技术的准确性和可重复性(参见图 4)。100 多次的重复测量,归一化标准偏差低于 ±0.25%,说明这项研究有很强的测量可重复性。当假设规格极限为 14%(目标为 ±7%)时,记录的每个样本的量具方差低于 10%。


图4.嵌套量具可重复性和可靠性研究的代表性结果,用于确定以下条件的铝镓氮层中的铝成分:(a )完整的常关氮化镓HEMT结构(埋层);(b)去除了p型GaN盖层的等效HEMT结构(表层)。
掺杂控制
在常关氮化镓 HEMT 中,镁掺杂会影响多种元器件特性,包括鲁棒性,截止态泄漏和阈值电压。研究氮化镓的先驱者投入了很多精力来开发实现镁掺杂的工艺,并在 1990 年代取得了成功,使氮化镓可以取代 ZnSe 并成为制造蓝色和绿色LED 和激光器的最佳材料。在随后的几十年中,从事氮化镓技术的人们在了解镁掺杂方面取得了长足的进步,其自补偿机制已被研究群体探究和讨论[5]。
尽管取得了这些进步,但氮化镓 HEMT 中的镁掺杂特性仍然是一个复杂性问题。这些问题包括源于镁受体和穿透位错之间的相互作用导致的增强的泄漏路径 [6]。
测量氮化镓中镁掺杂的传统技术是二次离子质谱(SIMS)。与霍尔效应测量一起使用,它使工程师能够发现所结合的镁与电活性镁的比率。不幸的是,SIMS 和霍尔效应测量都具有破坏性,前者有时甚至需要将样品送到专业实验室进行测试。
但是,由于我们通过定量阴极荧光法测定镁参杂量的专有技术,原地和异地 SIMS 测量不再需要漫长的等待时间。我们的方法基于详细的光谱分析,对电子物质相互作用和阴极荧光技术以及材料特定的专业知识有深入的了解。
为了证明定量阴极荧光光谱法测定镁掺杂量的可靠性,我们将测定结果与 SIMS 提供的结果进行了比较。在对多个样品进行测量后,SIMS和定量阴极荧光测定的镁参杂量的均方根误差为3.8%。为了确定技术的可重复性,我们进行了嵌套量具的可重复性和可靠性研究(见图 5)。这项研究证实了定量阴极荧光测定法良好的可重复性,当假设 60%的规格极限(目标 ±30%)和量具偏差低于 10%时,在 100 次重复测量中标准方差低于 ±1%。

图5.嵌套量具可重复性和可靠性研究的代表性结果,用于确定完全常关氮化镓HEM 结构的p 型氮化镓层中的镁浓度。
三大优点
我们方法的优点之一是测量过程不破坏材料。因此本技术可以避免晶片的定期破坏性的性能测试 - 考虑到其他所有替代技术都具有材料破坏性,本技术将成为氮化镓 HEMT 中镁参杂量测定技术中的佼佼者。第二个突出的优点是该技术测量过程相对较快,可以从每个晶片的数十个位置进行采集,因此可以测试片内均匀性。第三个突出优点是该方法具有多功能性,可测量穿透位错密度,铝镓氮成分和镁掺杂量等。尽管该技术由于需要在真空下更换晶圆,使得更换待测样品耗费时间,但此技术为晶圆厂节省的空间与降低的反馈周期复杂性依然使其充满竞争力。(表 1 罗列了使用该技术的优势,同时概述了其他技术的优缺点)。

表1 Attolight解决方案分析氮化镓HEMT外延片的优势。
由于 Säntis300 平台的诸多优点,使它非常适合于研发实验室和生产工厂中的过程控制与无损反馈。考虑到该技术可提供其他技术无法提供的深入分析,以及对现有指标的更快的测定,该技术将推动实验室提高效率、缩短开发周期,同时也可助力现有商业化产品提升产能。
| 标签: | Attolight,GaN,半导体 |

