400-6699-117转1000
您好,欢迎您查看分析测试百科网,请问有什么帮助您的?



诚信认证:
工商注册信息已核实! 扫一扫即可访问手机版展台
扫一扫即可访问手机版展台
| 参考报价: | 面议 | 型号: | 微型采样系统 |
| 品牌: | 日立 | 产地: | 日本 |
| 关注度: | 259 | 信息完整度: | |
| 样本: | 典型用户: | 暂无 |
400-6699-117转1000
优异的高效分析性能
微型采样方法(已在日本和美国取得专利)已在半导体器件分析领域成为一款工具,它正迅速向更小制样方向发展。仅用一小时左右即可获得一个微小样品,以便于STEM分析,其定位精度可达到0.1 µm以下。
特点
聚焦离子束(FIB)微采样装置和聚焦离子束(FIB)微采样方法
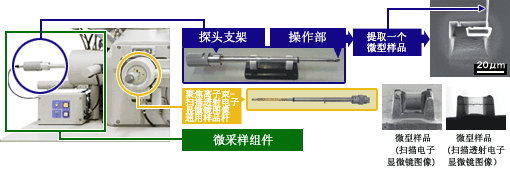
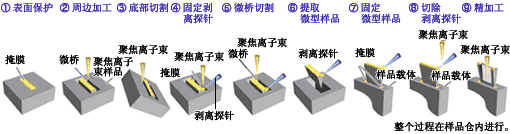
聚焦离子束(FIB)微柱状制样实例
一个微柱状样品,包含一个直接从半导体器件上准确地切割下来的分析点。改变入射聚焦离子束(FIB)的方向,把微样品切割或加工成任意形状。
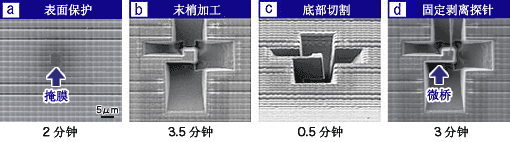

系统配置实例
聚焦离子束-扫描透射电子显微镜系统
新开发的半导体装置评估系统由FB2200聚焦离子束(FIB)系统和HD-2700 200 kV(STEM)扫描透射电子显微镜构成。从对材料缺陷(组织)的搜索到亚纳米薄膜高精度结构分析,只要几小时即可完成。
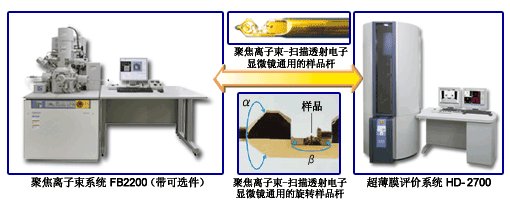
聚焦离子束-透射电子显微镜(扫描透射电子显微镜)(FIB-TEM(STEM))的样品杆可互换共用
观察实例
DRAM 观察实例
针尖顶端的微柱状样品SEM像
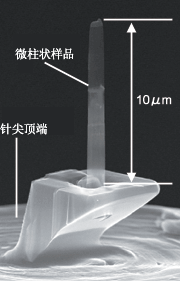
微柱状样品的明场STEM像
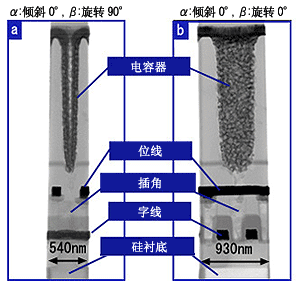
聚焦离子束(FIB)微型采样系统用于STEM分析信息由日立高新技术公司为您提供,如您想了解更多关于聚焦离子束(FIB)微型采样系统用于STEM分析报价、型号、参数等信息,欢迎来电或留言咨询。
注:该产品未在中华人民共和国食品药品监督管理部门申请医疗器械注册和备案,不可用于临床诊断或治疗等相关用途

